來源 :钜亨網
台積電竹南先進封測廠 AP6 今年第三季起即将量産,由于此次除了既有的 2D/2.5D 封裝外,也将進行大規模的 3D 封裝量産計劃,業界均緊盯此次量産後的市場反應,并觀察未來市場走向。
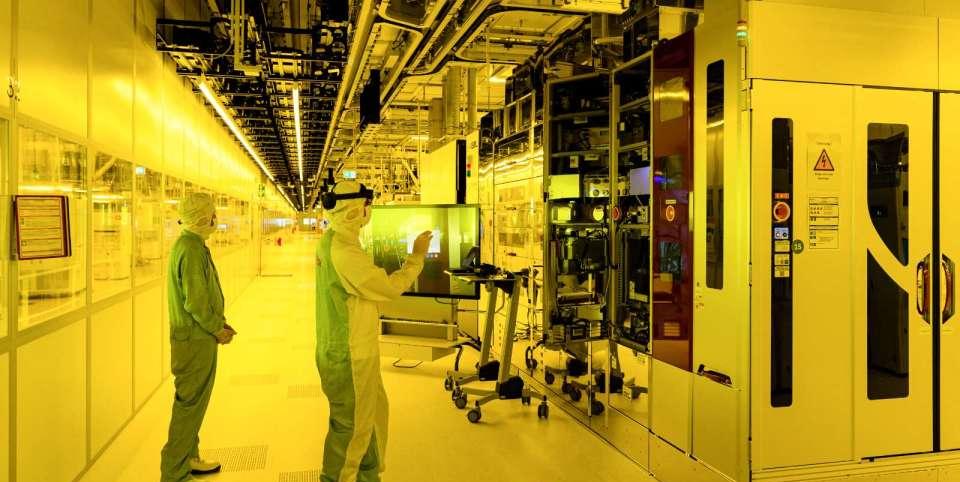
過去數年來,台積電先進封裝技術不論是 InFO、CoWoS 業績皆穩健成長,其中,2.5D InFO 随着蘋果 A 系列手機處理器銷量增加,成為台積電先進封裝的主要營收來源,估達 70% 左右。
随着近來 AI、HPC 應用興起,CoWoS 成長幅度更勝 InFO,加上先前耕耘的 TSV 技術,采用更厚銅的連接配接方式,讓 CoWoS 更具優勢,也獲AMD采用,帶動 CoWoS 占整體先進封裝營收比重攀升至 30%,分散産品集中風險。
台積電為延續摩爾定律,也在前年推出 3D Fabric 平台,藉由 3D 封裝前段的矽堆棧與後端的先進封裝技術,強化架構彈性、提高效能、縮短上市時間與成本效益等,為因應未來需求,也建立竹南廠 AP6,主要就是提供 SoIC、WoW 技術。
業界也屏息以待台積電今年 3D 封裝量産後的市場反應,如客戶群與應用擴充,首要瞄準對象就是既有客戶,不僅将現有産品從 2.5D 更新至 3D 封裝制程,也把更多産品從 2D 改為 2.5D 封裝。
除了既有客戶外,随着各家品牌大廠紛紛跳進自主設計晶片的行列,外界也觀察,此次能否吸引實力更堅強的新客戶加入 3D 封裝行列,屆時皆有助台積電先進封裝的營收規模、銷售單價再提升,對機器裝置的需求也将增加,對台灣各家裝置廠呈現正向循環。
- END -